Идея выпускать процессоры и даже SSD из цельных кремниевых пластин может оказаться более популярной, чем представляется. Сложность и стоимость таких решений ― вот главные препятствия на пути к однопластинным чипам. Снизить влияние каждого из этих отрицательных факторов могут оптимально разработанные техпроцессы. Тайваньская компания TSMC берёт эту задачу на себя и рассчитывает на множество новых клиентов.

Один кристалл процессора Cerebras рядом с клавиатурой
Как сообщают источники, на днях TSMC сообщила о разработке техпроцесса упаковки InFO SoW (Integrated Fan-Out Silicon on Wafer), который предназначен для производства однопластинных процессоров. Такой процессор TSMC уже выпускает по заказу компании Cerebras. Это чип, если так можно сказать о кристалле со сторонами 21,5 см, изготавливается из целой 300-мм кремниевой пластины с использованием 16-нм FinFET техпроцесса. Упаковка такого кристалла в корпус потребовала уникальных работ, в том числе выполненных вручную. Стоимость такого процессора превышает $2 млн. Автоматизация и развитые процессы упаковки и тестирования могут помочь снизить цену вопроса.
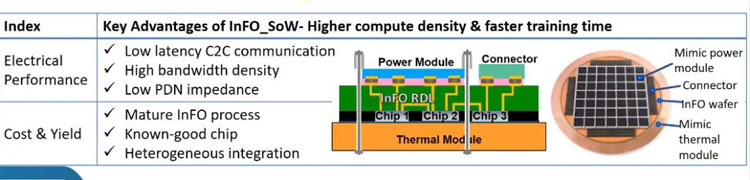
Упаковка InFO SoW компании TSMC
Упаковка InFO SoW является следствием развития техпроцесса упаковок Integrated Fan-Out и InFO-WLP (wafer-level processing). В первом случае отдельные кристаллы вырезаются из пластины и пакуются отдельно, что даёт простор для выходных (посадочных) контактов, но ведёт к увеличению размеров чипа (упаковки). Во втором случае часть операций по упаковке проводятся до разрезания пластины на кристаллы, что делает чипы меньше, включая упаковку, но ограничивает число посадочных контактов. Техпроцесс InFO SoW совмещает оба метода, позволяя обрабатывать пластину целиком и ни в чём не ограничивать суперпроцессор.
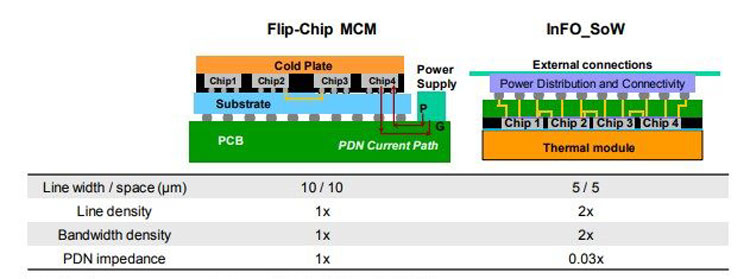
Сравнение обычной многокристальной упаковки и InFO SoW
В методе InFO SoW сама пластина с не разрезанными процессорами служит подложкой и «печатной платой». В процессе упаковки поверх кристаллов устанавливаются модули питания и внешние интерфейсы. Модули питания через толстые сквозные отверстия соединены шиной с элементом охлаждения, который также отводит тепло от кристаллов-процессоров. В рамках 16-нм техпроцесса пластина-процессор Cerebras требует отвода 7 кВт мощности в виде тепла. Предложенная TSMC упаковка вместе с жидкостной системой охлаждения с этим прекрасно справляются.

Преимущества упаковки InFO SoW
Из других преимуществ упаковки InFO SoW можно отметить увеличение полосы пропускания сигнала и снижение сопротивления межчиповых соединений, что конвертируется в 15-процентное снижение потребления соединений между кристаллами. При этом полоса пропускания увеличена в два раза, а сопротивление снижено на 97 %. Также уменьшаются задержки обращения к чипам. TSMC готова предложить лучшее в этой новой сфере производства чипов из цельной кремниевой пластины. Интересно, кто ещё готов этим воспользоваться?
Источник:






